|
Make: |
Physical Eelctronics, USA |
|
Model: |
Trift V nano TOF |
Time-of-Flight
Secondary Ion Mass Spectrometry (TOF-SIMS) is a technique in which an ion beam (primary ion)
is irradiated on a solid sample and mass separation of the ions emitted from the surface
(secondary ions) is performed using the difference in time-of-flight (time-of-flight is
proportional to the square root of the weight).
TOF-SIMS can obtain information regarding elements or molecular species within 1 nm of
the sample surface at a very high detection sensitivity.
 Mass spectrum study for elemental and
organic composition Mass spectrum study for elemental and
organic composition
 Elemental and organic species mapping Elemental and organic species mapping
 Dopant and impurity depth profiling Dopant and impurity depth profiling
 Elemental 3D reconstruction for profile
study Elemental 3D reconstruction for profile
study
 Composition and impurity measurements of
thin films (metals, dielectrics, SiGe) Composition and impurity measurements of
thin films (metals, dielectrics, SiGe)
 High-precision matching of process tools
such as ion implanters High-precision matching of process tools
such as ion implanters
|
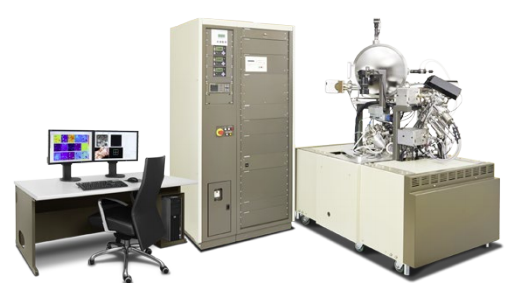
 Nanodevices
Nanodevices
 Polymer blends
Polymer blends
 Pharmaceuticals
Pharmaceuticals
 Thin films/surface coatings Thin films/surface coatings
 corrosion corrosion
 Catalysis Catalysis
 Geologic materials Geologic materials
 Glass industries Glass industries
|